
Key Market Sectors
- 3-D wafer-level packaging
- MEMS
BrewerBOND® 230 Material vs. Wax
| Wax | BrewerBOND® 230 Material | |
|---|---|---|
| Thickness Range | ~ 10 – 35 µm | 20 µm – 150 µm |
| Coating Throughput | Requires multiple coats | Single-coat process |
| Bonding Temperature Range | 95ºC - 110ºC | 100ºC – 130ºC |
| Debonding Temperature Range | 95ºC - 110ºC | 150ºC – 200ºC |
| Thermal Stability Temperature Range | < 120ºC | ≤ 250ºC |
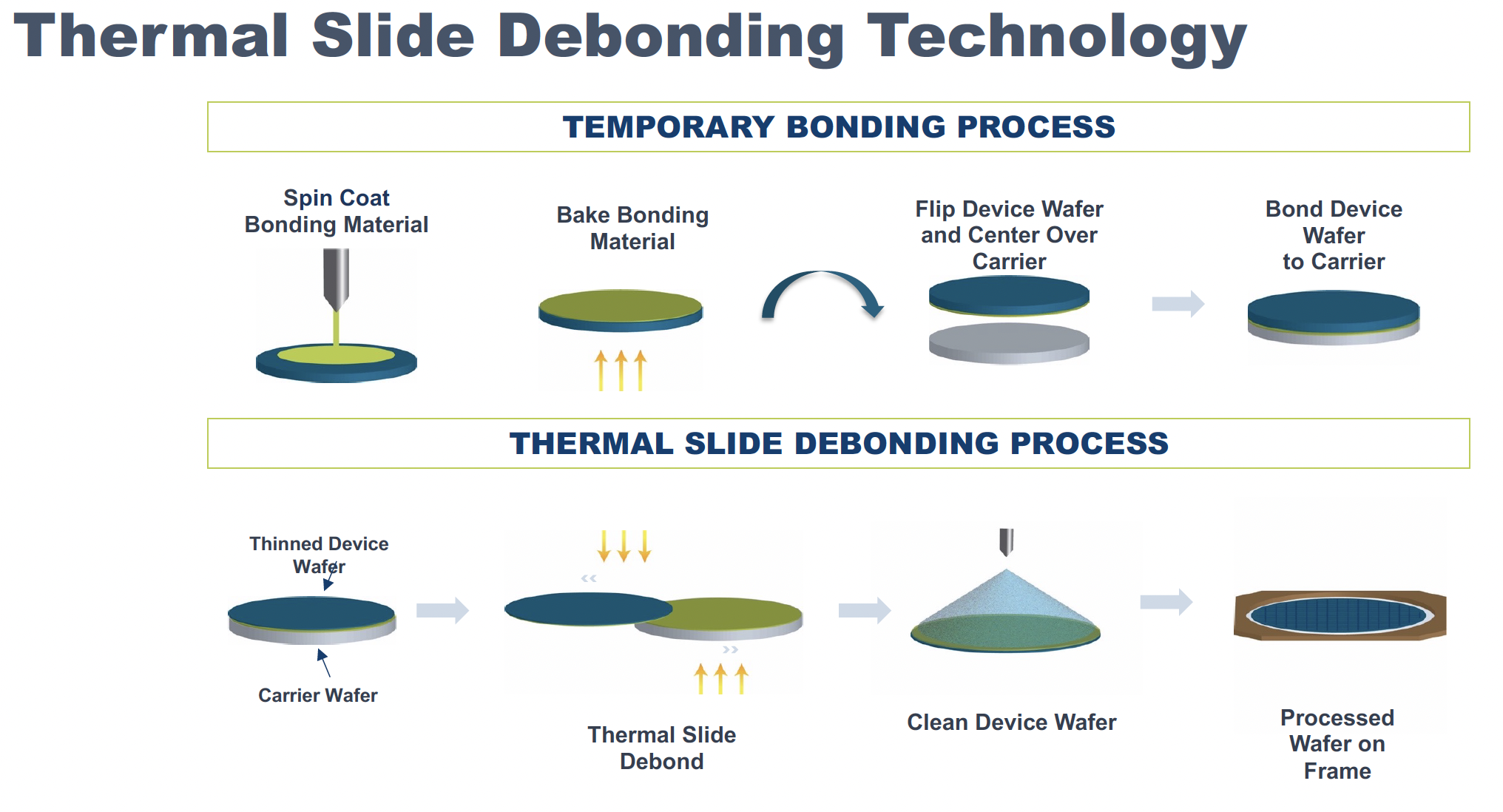
Learn how BrewerBOND® 230 material is replacing wax. [download]
BrewerBOND® 230 material is an organic coating for temporary wafer bonding for MEMS and 3-D wafer-level packaging applications. BrewerBOND® 230 material enables thinning and backside processing through effective bonding and subsequent thermal slide debonding. The material has been developed for use in through-silicon via creation, finishing, and redistribution layer completion in processes up to 220°C.
Benefits
- Low-stress material for high-stress applications
- Broader thickness range in a single coat: up to ~110µm
- Broad temperature range for thermal separation: 150°C to 200°C
- Survives standard back-end-of-line thermal processing
Related Products

BrewerBOND® T1100/C1300 Series Materials enable our unique VersaLayer solution for high-temperature and high-stress applications found within the semiconductor industry.

BrewerBOND® 305 temporary wafer bonding material is an organic coating that enables back-end-of-line (BEOL) processing of ultrathin wafers using standard semiconductor equipment.

